

精密激光加工,助力BGA返修制造
-----武汉博联特全球首创激光BGA返修系统
随着3C电子产品越来越来向轻薄化发展,PCB主板及电子元器件包括BGA芯片也就必须向着高密、薄化设计发展。传统红外及热风在对BGA芯片进行拆卸及焊接时,大面积加热及热风风向的不可控性,容易造成相邻或是背贴BGA芯片二次超温重熔,造成BGA芯片性能失效。激光凭借高方向性发散角小,配合我司自主研发的高精度温度控制系统, 完成了对高密BGA芯片临、背贴的拆卸与焊接。
![]() 非接触式焊接,无应力、无污染、升温快、热影响区域小;
非接触式焊接,无应力、无污染、升温快、热影响区域小;
![]() PC控制,可视化操作;
PC控制,可视化操作;
![]() 同轴温控,温度反馈,实时监测BGA芯片温度,恒温控制,精准焊拆。
同轴温控,温度反馈,实时监测BGA芯片温度,恒温控制,精准焊拆。
应用场景
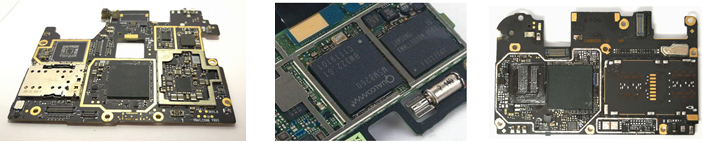
双层BGA 单层BGA临贴 BGA背贴
1、BGA芯片最小禁布可达0.8mm.
2、背贴BGA芯片PCB板厚度可薄至0.5mm.
武汉博联特一直致力于特种激光精密加工产品的开发与专研,结合公司强大的研发背景与高校支撑,开发出了一系列的激光精密加工以及激光自动化产品,弥补了多个行业应用空白,得到了众多世界500强公司的一致好评。
由于目前3C市场(手机,智能穿戴等)普遍存在的BGA设计的高密集,高集成的特点(众多功能化的需求),普遍存在BGA采用传统方式拆卸与焊接良率不高,存在着众多核心器件的报废,牺牲了众多的成本与资源。
武汉博联特开发的BGA返修系统,利用激光非接触式加热及热辐射面小,再加上同轴温控的独特性,保证临贴、背贴BGA内锡球的温度低于200℃。可任意变换加工路径的方便性,能适应不同大小尺寸的BGA拆焊。有效的解决了BGA的拆焊难题,极大的提高了良率,节约制造成本,直接提高产品运用率。


上一篇:磁性线圈漆包线激光加工工艺
下一篇:恒温激光锡焊,助力LDS精密加工
相关应用案例


关注微信

关注微信